
Privacy statement: Your privacy is very important to Us. Our company promises not to disclose your personal information to any external company with out your explicit permission.
Con el rápido avance de los dispositivos electrónicos hacia la miniaturización, la multifuncionalidad, el alto consumo de energía y la mayor confiabilidad, ha surgido la tecnología de integración tridimensional de alta densidad para dispositivos microelectrónicos. Sin embargo, el desarrollo de la integración de alta densidad se ve limitado por las elevadas temperaturas de unión causadas por la concentración térmica dentro de los chips, lo que compromete significativamente el rendimiento y la confiabilidad del dispositivo.
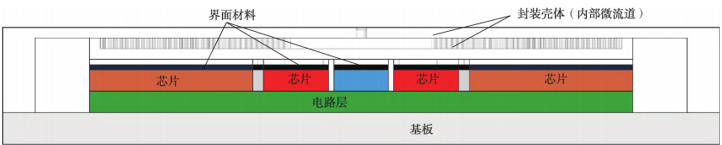
Los chips integrados presentan estructuras multicapa que comprenden capas de sustrato, capas de circuitos de chips, chips y placas frías de carcasa de paquete. La placa fría de la carcasa del paquete incorpora microcanales que disipan el calor de los chips de la capa del circuito mediante transferencia de calor por convección líquida al tiempo que garantiza una distribución uniforme de la temperatura del chip. Los materiales de interfaz térmica flexibles (TIM) sirven de puente entre la placa fría de la carcasa del paquete y la capa del circuito.
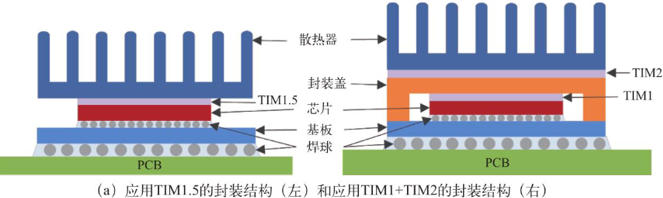
Los materiales de interfaz térmica (TIM) son componentes críticos de disipación de calor que llenan espacios microscópicos entre superficies para mejorar directamente el rendimiento térmico. Los TIM generalmente se aplican entre el chip y la tapa del paquete (TIM1), el chip y el disipador de calor (TIM1.5) y la tapa del paquete y el disipador de calor (TIM2). La alta conductividad térmica y la confiabilidad de los TIM garantizan una rápida transferencia de calor entre interfaces. El enfoque predominante de gestión térmica para chips de alta potencia informática todavía se basa en materiales TIM1 de resistencia térmica ultrabaja para conducir rápidamente el calor desde el interior del chip hasta la carcasa del paquete. Luego, el calor se transfiere a través de materiales TIM2 a una placa de enfriamiento líquido, que lo disipa rápidamente al ambiente externo a través del rápido flujo de su fluido de enfriamiento interno.

Contactar proveedor

Privacy statement: Your privacy is very important to Us. Our company promises not to disclose your personal information to any external company with out your explicit permission.

Fill in more information so that we can get in touch with you faster
Privacy statement: Your privacy is very important to Us. Our company promises not to disclose your personal information to any external company with out your explicit permission.